在印刷电路板(PCB)领域,厚度对性能和耐用性起着至关重要的作用。通常定义为厚度超过3.0毫米的厚PCB,在需要高功率处理、散热及机械强度的应用中不可或缺。这些包括工业机械、汽车系统、高端电子产品,甚至医疗设备。随着对更坚固、更可靠PCB设计的需求不断增长,对厚PCB的需求也日益凸显。
然而,制造厚PCB面临着重大挑战。材料厚度的增加会影响生产过程的各个环节,从钻孔和成型,到电镀和组装。在本文中,我们将探讨生产厚度超过3.0毫米PCB时所涉及的主要难点,重点关注机械加工、层压、电镀和焊接等环节。我们还将提供行之有效的策略,以克服这些挑战并确保高质量的成果。让我们深入探讨厚PCB制造的复杂性,以及有助于缓解这些问题的解决方案。
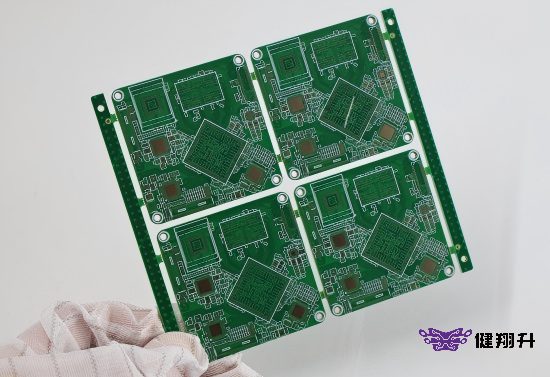
为什么PCB厚度超过3.0mm会带来制造挑战?
PCB厚度超过3.0毫米会带来制造挑战,因为钻孔、层压、电镀和组装的复杂性增加,需要采用专用设备和工艺以确保精度和可靠性。
什么是厚PCB制造?常见的挑战有哪些?
厚PCB制造是指生产厚度超过3.0毫米的印刷电路板。这类PCB应用于特殊领域,例如大功率电子设备、汽车系统和工业设备。由于材料厚度增加,制造厚PCB会面临独特的挑战。主要问题涉及机械加工、层压、电镀和组装,而随着厚度增加,这些问题都会变得更加复杂。
厚度的增加影响了生产的每个环节。例如,钻更深的孔变得困难,因为刀具需要穿透更多的材料。层压工艺也变得更加复杂,因为厚板材容易因热量分布不均而发生翘曲。此外,电镀工艺在处理较深的孔洞时面临困难,导致铜层沉积不均匀。所有这些因素都使得实现更厚PCB所要求的精度和可靠性变得更加困难。
简而言之,制造厚PCB需要高度专业化的设备和工艺,以及对细节的更多关注和更严格的质量控制措施。
各种PCB厚度(3.0mm、4.0mm、6.0mm及更厚)之间的技术差异
随着PCB厚度的增加,其生产所面临的技术挑战也日益增大,每种厚度级别都会带来特定的问题。
3.0毫米PCB:达到这一厚度时,制造商开始面临钻孔困难以及层压过程中轻微翘曲等问题。不过,借助标准设备和技术,这些挑战仍可有效应对。
4.0毫米PCB:在4.0毫米厚度下,挑战变得更加明显。为通孔和导通孔所需的更深钻孔会导致钻头磨损风险增加,且孔的质量也更难保证。此外,层压过程也更为复杂,因为内层可能无法正确粘合,从而导致各层之间的结合强度降低。
6.0毫米及更厚的PCB:超过6.0毫米后,制造难度将显著增加。深孔钻孔容易出现钻头断裂和孔位偏移等缺陷。层压工艺也面临散热问题,导致压制过程中难以保持均匀压力,从而可能引起电路板翘曲。此外,由于难以均匀地在深孔中镀层,电镀难题进一步加剧,导致铜分布不均。
PCB越厚,所需的专用设备和先进技术就越多,这会增加生产成本和复杂性。

制造厚PCB的主要挑战有哪些?
制造厚PCB的主要挑战包括钻孔、层压、电镀、焊接以及处理专用材料和设备等方面的困难,而随着板厚的增加,这些挑战会变得更加复杂。
1. 机械加工挑战
钻井问题:
在厚PCB的加工中,钻孔是最困难的工艺之一。随着板厚增加,钻更深的孔会因多种原因而变得极具挑战性:
l 孔深增加与排屑难度加大:随着板材厚度增加,钻头需要穿透的材料更多,这使得排出切屑和碎屑变得更加困难。由此导致摩擦增大、发热量升高,钻头磨损或断裂的风险也随之增加。
l 高纵横比导致孔位偏移:较厚的电路板通常需要更深的孔。当孔深与孔径之比(即纵横比)过大时,钻头更容易偏离预定轨迹,从而导致孔位偏移。这会导致孔位定位不佳,从而影响装配流程。
l 孔壁质量差与“喇叭口”效应:在厚PCB中,钻孔越深,孔壁往往越粗糙,或孔口处出现不理想的扩径现象(也称为“喇叭口”效应)。这可能损害孔的完整性,并影响整个电路板的质量。
塑造问题:
l V形切割失效与边缘崩缺:用于电路板分离的传统V形切割方法,对于较厚的PCB可能无法奏效。切割深度受到限制,若强行加深切割深度,可能导致边缘崩缺、裂纹,甚至断裂。这一点在最终产品对精度要求极高时尤为棘手。
l 难铣削与刀具磨损加快:铣削较厚板材需要更大的力量,这会加速铣刀的磨损。随着刀具变钝,其工作效率降低,导致产品质量下降,同时刀具更换频率也相应增加。
2. 层压与热应力控制挑战
树脂填充不足:
在较厚的PCB中,各层之间的距离增大,这可能导致层压过程中树脂流动不足。出现这一问题的原因是,用于粘合各层的树脂可能无法均匀流动以填满间隙,从而导致层间粘合不良。层与层之间的这种弱键合可能导致PCB在运行过程中失效,尤其是在承受应力时。
气泡与层间分离:
在高温高压层压过程中,材料中的气体和挥发性物质会被困住,从而形成气泡。这些气泡会导致PCB分层或出现薄弱点,降低其可靠性。高质量的厚PCB需要对层压工艺进行精确控制,以确保所有空气都被排出,并且各层能够有效粘合。
翘曲与变形:
由于PCB制造中使用了不同的材料(例如铜箔、预浸料和芯材),它们的热膨胀系数(CTE)各不相同。当PCB在层压过程中受热,随后冷却时,这些材料的膨胀和收缩速率不同,从而导致翘曲或变形。这一问题在较厚的PCB中尤为明显,可能导致电路板不适用于某些应用,例如精密表面贴装技术(SMT)组装。
3. 电镀挑战
铜镀层均匀性问题:
在厚PCB上电镀较深的孔时,存在铜层分布不均的风险。这种问题被称为“狗骨效应”,其表现为孔中央的镀层比边缘部位更薄。这会导致铜层厚度不均匀,进而影响PCB的电气性能和可靠性。
填充盲孔和埋孔:
厚型PCB通常带有盲孔或埋孔(即未贯穿整个电路板的孔洞)。这些孔洞在电镀过程中更难填满铜。如果孔洞未能充分填充,将影响信号传输并降低PCB的电气性能,使其不适用于高频或大功率应用。
4. 贯通孔插装与焊接问题
焊料润湿不良(焊料“吸液”问题):
在厚PCB中,由于材料厚度增加,通孔元件(如电阻或电容)的焊接难度更大。焊料毛细现象是指焊料无法充分渗入孔内,从而导致焊点形成不足。此问题可能导致连接薄弱,在机械应力或高温下增加失效风险。
组件安装问题:
对于安装在厚PCB上的重型元器件,由于其重量和机械力的作用,焊点会承受更大的应力。这些元器件可能因疲劳而最终导致焊点断裂,进而引发元器件失效。在设计PCB时,必须特别注意处理元器件的重量,并确保元器件得到牢固安装。
5. 设备与材料限制
设备兼容性:
许多自动化制造系统,包括输送机系统、曝光机和蚀刻线,对其可处理的电路板最大厚度都有限制。例如,一些系统的设计无法处理厚度超过3.2毫米的PCB,这意味着对于较厚的电路板,需要额外的投资或对工艺进行调整。这增加了生产的复杂性和成本。
材料要求:
较厚的PCB需要采用高性能材料,例如高-Tg(玻璃化转变温度)和低CTE(热膨胀系数)的基板。这些材料能够更好地承受生产过程中的热应力,但成本也更高。此外,使用这些专用材料会增加制造工艺的复杂性,使成本更高,且更难实现高产量。
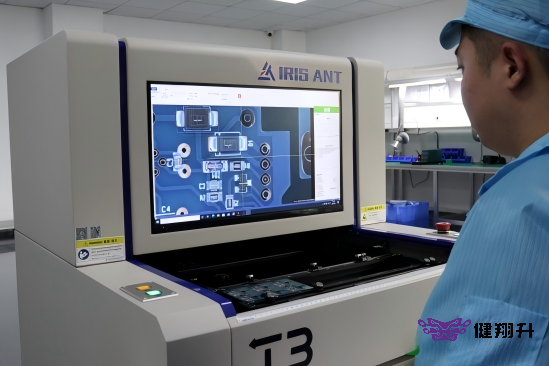
如何克服厚度超过3.0mm的PCB制造挑战?
为克服厚度超过3.0毫米的PCB制造难题,优化钻孔与成型工艺,改进层压流程,升级电镀方法,在设计与制造过程中密切协作,并实施严格的质量控制措施。
1. 优化机械加工工艺
钻孔优化:
为应对厚PCB板的钻孔难题,制造商可采用多种技术来提高精度并减少刀具磨损:
l 阶梯钻孔(啄式钻孔):该技术采用分阶段钻孔,每次进给后钻头都会退刀并清除切屑。这有助于减少热量积聚,防止钻头断裂,并提高孔的质量,尤其适用于深孔加工。
l 使用高品质钻头:采用钨 carbide 等专业高品质钻头,可提高钻孔精度并延长刀具寿命。优化转速和进给速度等钻孔参数也有助于减少摩擦和刀具磨损。
l 控制长径比并采用阶梯钻孔:为避免对准问题,务必使孔的长径比(深度与直径之比)保持在推荐范围内(通常小于10:1)。采用逐步增大钻头尺寸的阶梯钻孔方法,有助于确保更高的孔精度,并最大程度地降低偏移风险。
形状优化:
l 放弃V形切割,改用铣削工艺:对于厚PCB,传统的V形切割方法效率较低,尤其是在切割深度超过板厚2/3时。此时,可改用铣削或冲孔工艺,这种工艺能够实现更精确、更深的切割,同时不会损害电路板的完整性。
l 慢速铣削与多次走刀铣削:放慢铣削速度并采用多次走刀,可实现更平滑的切削效果,同时降低铣刀的磨损。这种方法还有助于在加工厚PCB时获得更高的精度。
2. 改进层压工艺
树脂填充:
适当的树脂流动对于确保厚PCB中各层的良好粘合至关重要。制造商可通过以下方法解决树脂填充问题:
l 使用高树脂含量的PP板材:选择树脂含量较高的预浸料板材,有助于确保在层压过程中树脂充分流动,即使在厚板中亦然。这有助于避免各层之间出现空洞和气隙。
l 多阶段温度压制:采用多阶段温度压制工艺,可确保树脂有充足的时间流动并填充各层之间的间隙,从而实现更佳的粘合效果。该工艺首先在较低温度下进行,以利于树脂流动,随后施加高压使板材固化。
l 使用缓冲材料与流道:在层压过程中,在PCB边缘添加缓冲材料并设置树脂流动通道,有助于引导多余的树脂和滞留的空气排出电路板,从而确保更好的粘合效果并防止分层。
减少翘曲:
层压后烘烤:层压完成后,对PCB进行烘烤以消除内部应力至关重要。烘烤工艺有助于缓解热应力,减少翘曲,并确保PCB在后续制造阶段保持平整。
3. 升级电镀技术
脉冲与水平电镀:
脉冲电镀:这种技术可提高深孔中铜沉积的均匀性。它通过周期性地开关电流,增强镀液的交换速率,确保铜层厚度均匀,从而减少“狗骨”效应。
l 水平电镀:这种方法采用水平电镀系统,可更好地控制深孔内的铜分布。它确保电镀液均匀分布,从而避免孔内壁出现铜层过薄的区域。
增强搅拌与超声波振动:
l 超声波振动:为提高深孔镀层的均匀性,可采用超声波搅拌。这有助于镀液更深地渗入孔内,确保铜层在整个孔内均匀沉积。
延长电镀时间:
l 更长的电镀时间:延长电镀时间可使铜均匀地沉积在深通孔和孔洞内,确保铜层厚度符合电气和机械性能的 required 标准。
4. 优化设计与制造协作
设计阶段:
l 放宽设计公差:在设计厚PCB时,适当加大线与焊盘之间的间距,并优化孔径大小,有助于降低制造工艺的复杂性,从而更轻松地实现生产中的一致质量。
l 背钻以优化信号质量:对于高速信号,采用背钻技术去除通孔中未使用的铜层(称为“stub”),可减少信号干扰并提升电气性能,尤其是在厚PCB中效果显著。
制造阶段:
l 添加工艺余量和定位孔:在制造过程中,添加额外的工艺余量和定位孔有助于提高对齐与定位的精度。这些调整使在钻孔、走线和电镀过程中更易于处理厚板,从而降低错位的风险。
5. 严格的质量控制与检验
电气连续性测试:
l 100%电气测试:每块厚PCB都应进行电气连通性测试,以确保所有电路均正确连接。这一点在厚PCB中尤为重要,因为其过孔和连接点可能更难通过人工检查。
横截面分析与3D X射线检测:
l 横截面分析:定期开展横截面分析,可帮助制造商检测镀层质量、涂层附着力及其他关键特性。同时,这也有助于在工艺早期发现内部缺陷。
l 3D X射线检测:对于深孔或埋孔,可采用3D X射线技术来检测PCB的内部结构。这种无损检测技术能够清晰地显示孔的质量、层间对齐情况以及整体制造完整性。
热应力测试:
l 高温焊接测试:为确保厚PCB的可靠性,进行高温焊接测试(如在288℃的熔融焊料中浸渍)至关重要。这有助于评估焊点的强度以及PCB在工作过程中承受高温的能力。

厚PCB制造中的常见误解与问题
在厚PCB制造中,常见的误解包括认为传统工艺能够应对所有厚度,而实际上,电镀中的“狗骨”效应、可焊性差以及翘曲等问题,往往是由方法不当和材料挑战所引发的。
误解:认为传统工艺能够应对所有厚PCB制造
在厚PCB制造中,一个常见的误解是认为专为标准、较薄PCB设计的传统工艺也可用于较厚的电路板。尽管传统方法可能适用于厚度不超过3.0毫米的电路板,但较厚的电路板由于钻孔、层压和电镀等工序的复杂性增加,需要采用专门的技术。在厚板材上使用标准设备和方法,往往会导致孔质量差、电镀不均匀、板面翘曲以及可靠性降低。
例如,对于厚PCB采用传统的V型切割方法,可能会因切割深度较大而导致边缘崩裂甚至板材断裂。同样,标准钻孔技术也可能导致钻头断裂或厚板上孔位偏移,从而影响PCB的整体性能。调整工艺并采用专为较厚PCB设计的合适设备和方法,对于确保制造成功至关重要。
常见问题1:电镀中的‘狗骨’效应
“狗骨”效应是指在厚层PCB的深通孔电镀过程中出现的一种问题,表现为铜沉积不均匀。当电镀液无法到达孔的中心时,就会发生这种现象:孔的边缘铜层较厚,而孔的中心区域则形成较薄的铜层。其结果是连接薄弱,电气性能受损。狗骨效应可能导致高功率或高频应用出现故障,因为PCB可能无法正常导电,甚至可能出现开路现象。
为此,可采用脉冲电镀或水平电镀方法,以提高镀层的均匀性,确保铜均匀地分布于深层通孔中。
常见问题2:可焊性差且焊料渗透不足
在厚PCB制造过程中,另一个挑战出现在焊接环节,尤其是在处理通孔元件时。由于焊料无法充分渗入深孔,常常会出现可焊性差的问题,而这一问题在厚PCB中尤为突出。因此,会形成不良的焊点,导致电气连接薄弱并可能引发机械故障。
特别是,波峰焊和手工焊在焊接较深通孔时,可能难以使焊料充分润湿。这会导致冷焊点、导电性能差以及在机械或热应力作用下焊点失效的风险等问题。为解决这一问题,制造商可能需要采用回流焊工艺并配合更先进的助焊剂,或使用预热技术,以提高焊料到达孔内各部位的能力。
常见问题3:制造过程中的翘曲与变形
在制造厚型PCB时,翘曲是一个常见问题。这是由于PCB中所用各种材料(如铜、预浸料和芯材)的热膨胀系数(CTE)存在差异所致。在层压过程中,PCB被加热,随后冷却,这些材料的热胀冷缩速率各不相同,从而导致电路板发生变形或弯曲。
翘曲在表面贴装技术(SMT)组装中尤其成问题,因为元件的精确贴装至关重要。翘曲的电路板会使元件难以正确对齐,从而导致焊点质量差,并影响最终产品的可靠性。为应对这一问题,制造商通常采用多阶段固化工艺和烘烤后处理技术,以降低内部应力并保持板材平整。
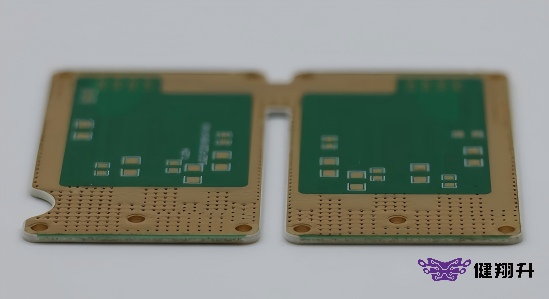
结论
制造厚PCB需要克服一系列挑战,包括钻孔、电镀、焊接和翘曲等方面的难题。随着电路板厚度的增加,实现高精度和可靠性能的复杂性也随之增大。这些障碍需要专门的技术、先进的设备,以及对所涉及材料和工艺的深刻理解。
这时,健翔升就派上用场了。作为一家经验丰富的PCB和PCBA供应商,我们致力于提供高品质的产品,包括厚PCB,具备卓越的精度与性能。凭借多年的专业经验,我们采用尖端技术,应对厚PCB制造过程中特有的挑战,确保每个项目都达到最高标准。无论您需要标准PCB还是高性能厚板,健翔升都是您值得信赖的优质解决方案合作伙伴。立即联系我们,了解我们如何满足您的需求,助力您的设计梦想成真。
常见问题
当PCB厚度超过3.0mm时,钻孔难度如何增加?
随着PCB厚度超过3.0mm,由于钻孔深度增加,钻孔难度也随之加大。这种更深的钻孔会导致若干问题:
l 排屑难度:孔越长,钻头有效排出切屑的难度就越大。这会增加摩擦,导致温度升高,并给钻头带来额外的负荷。
l 钻头断裂:由于阻力和摩擦力增大,钻头在加工过程中更容易断裂,尤其是在钻孔较深时。这不仅会影响效率,还可能损坏PCB材料。
孔位偏移:随着孔深与孔径之比(长径比)的增大,钻头可能会发生偏移,从而导致孔位偏移。这可能造成孔位定位不准确,进而影响多层PCB的对齐及整体功能。
为应对这些挑战,建议采用先进的钻孔技术,如阶梯钻孔(台阶钻孔)以及使用高质量、耐用的钻头,以确保钻孔精准高效。
厚PCB中树脂填充不足如何影响制造质量?
在厚型PCB中,层压过程中树脂的填充对于实现牢固的层间粘合至关重要。如果树脂未能完全填充各层之间的空间,将会导致一系列问题:
l 空洞形成:树脂流动性不足可能导致PCB内部出现气泡或空洞,尤其是在内层。这会削弱电路板的结构完整性,并可能导致分层或层间分离。
l 层间粘合度降低:恰当的树脂填充可确保各层之间具有牢固的粘合。若缺乏这一条件,各层之间可能无法良好结合,导致层间强度下降,从而影响PCB的整体可靠性,尤其是在承受机械应力或温度波动时。
为避免这种情况,重要的是使用高树脂含量的预浸料板材,并采用多阶段温度压制工艺,以确保层压过程中树脂充分流动。
如何解决厚PCB电镀中的“狗骨”效应?
在电镀过程中出现的“狗骨”效应是指铜镀层不均匀,通常导致深孔边缘的铜沉积较厚,而孔中心的铜沉积则较薄甚至完全无铜。这一问题会降低导电性,并可能导致电路开路或连接不良。为克服这一挑战:
l 脉冲电镀:脉冲电镀通过周期性地开关电流,有助于增强电镀液的流动,使铜更有效地到达深通孔的中心,从而确保孔内铜层厚度均匀。
l 水平电镀:在水平电镀中,电镀液均匀地分布于整个PCB上,这有助于更好地渗入深层通孔,并实现更一致的铜沉积。
l 超声波振动:在电镀过程中加入超声波搅拌,有助于进一步提升电镀液对深层通孔的渗透能力,改善铜层均匀性并减少狗骨效应。
通过采用这些先进的电镀方法,制造商能够实现均匀的铜沉积,并确保长期可靠性。
如何降低厚PCB的翘曲?
在制造过程中,由于热应力导致PCB中不同材料的膨胀或收缩速率不同,从而产生翘曲现象。在厚PCB中,这种现象更为明显,可能导致贴装时出现错位或困难。为尽量减少翘曲:
l 延长低温保温时间:在层压过程中,延长低温保温时间可使树脂更好地流动,并有助于释放被困气体。这能降低内应力,减少加热和冷却阶段出现翘曲的可能性。
l 后烘处理:层压工艺完成后,通过采用受控的逐步加热工艺对PCB进行后烘处理,有助于消除残余的内部应力。
l 材料选择:选用低热膨胀系数(CTE)的材料,例如高Tg基板,有助于最大限度地减小各层之间膨胀率的差异,从而降低翘曲发生的几率。
这些技术协同作用,确保了PCB在整个制造过程中保持平整与稳定,从而提高了SMT贴装时元件放置的精度。
为什么与制造商尽早沟通对厚PCB生产至关重要?
由于以下原因,与PCB制造商的早期沟通对于厚PCB的生产至关重要:
l 复杂制造工艺:厚PCB会带来独特挑战,例如更深的钻孔、特殊的层压工艺以及更高的材料成本。尽早开展协作能够确保设计针对这些挑战进行优化,并使制造商能够提前规划并应对任何潜在问题。
l 生产成本与时间增加:由于涉及更多工序,厚PCB通常需要更长的时间并产生更高的成本。制造商若能及早讨论这些方面,便可设定切合实际的期望,确保按时交付,避免出现意外延误或成本超支。
l 避免设计与制造的差异:如果制造商和设计师未能及早沟通,可能会导致设计意图与制造可行性之间出现不匹配。及早开展讨论有助于防止错位,并确保设计针对生产进行了优化。
总体而言,及早沟通有助于使生产更加顺畅,并确保最终产品符合所需规格,从而提高效率、质量和成本效益。
