一、什么是SMT回流焊
SMT 回流焊(Reflow Soldering)是表面贴装技术(SMT)中实现元器件与 PCB 焊盘电气连接和机械固定的核心工序。其原理是通过对印刷焊膏(由焊锡粉末和助焊剂组成)的 PCB 板进行阶梯式加热,使焊膏经历 “熔化 - 润湿 - 凝固” 过程,最终形成可靠焊点,将表面贴装元器件(如电阻、电容、芯片等)永久固定在 PCB 上。
回流焊是 SMT 生产线中 “印刷焊膏→元器件贴装→炉前 AOI 检测→回流焊→炉后 AOI 检测” 流程的关键环节,位于炉前 AOI 之后,是将前期工艺成果(合格的焊膏印刷和元器件贴装)转化为稳定焊点的 “成型步骤”。
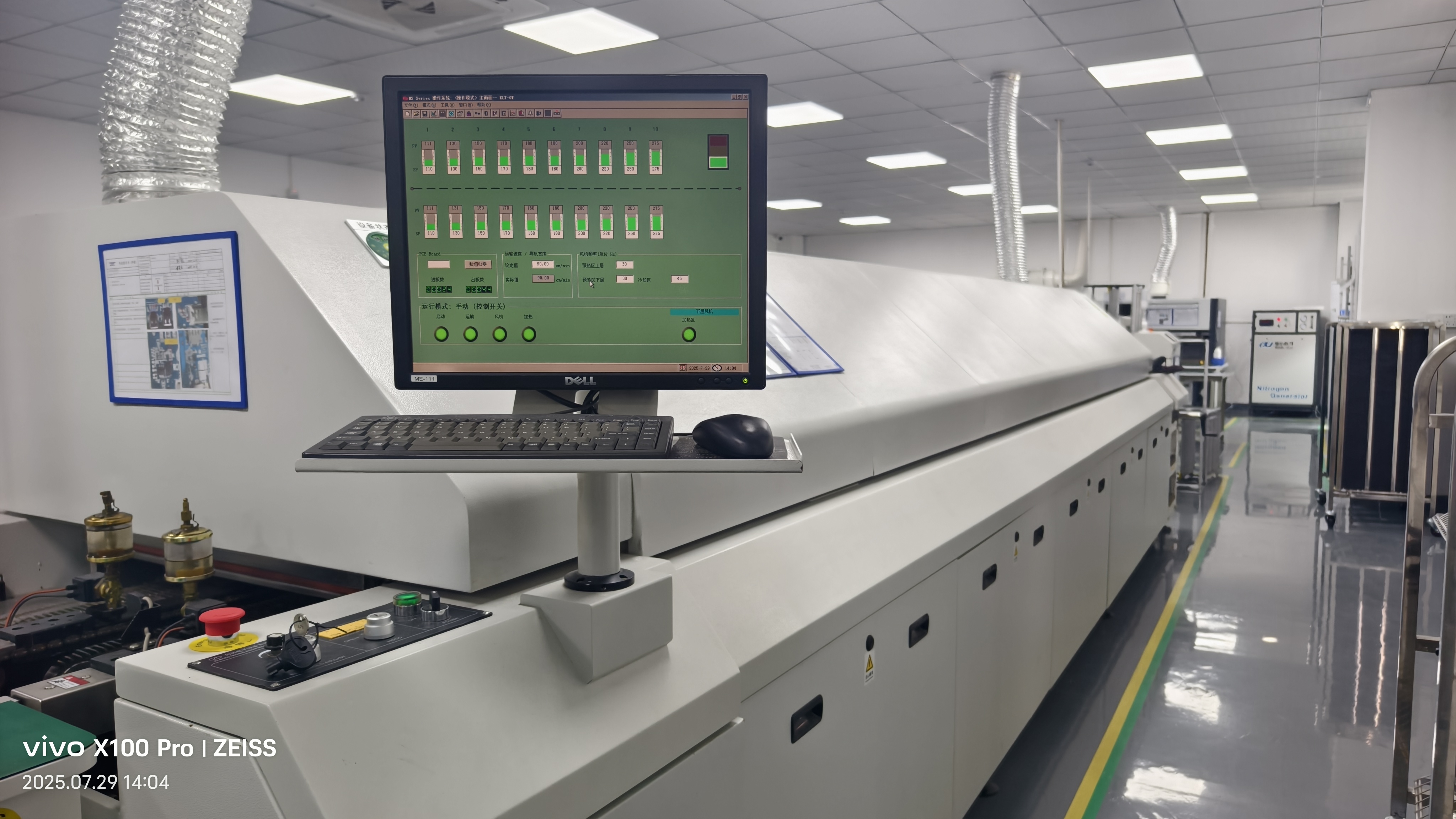
二、SMT 回流焊的主要作用
1. 实现可靠的电气与机械连接
焊膏在回流焊过程中熔化后,会润湿 PCB 焊盘和元器件引脚表面,形成合金层(如锡 - 铜合金),既保证电流导通(电气连接),又通过焊点强度固定元器件(机械连接),是电子设备功能实现的物理基础。
2. 适应高密度、小型化元器件的焊接需求
对于 01005(0.4mm×0.2mm)等微型元件、BGA(球栅阵列)、QFP(Quad Flat Package)等引脚密集的芯片,回流焊通过均匀加热确保所有焊点同步熔化,避免人工焊接的漏焊、虚焊问题,满足 SMT“高密度、高精度” 的工艺要求。
3. 激活助焊剂,去除氧化层
焊膏中的助焊剂在回流焊的预热阶段会挥发并去除 PCB 焊盘和元器件引脚表面的氧化层,为焊锡熔化后的润湿提供洁净表面,减少焊点缺陷(如空洞、冷焊)。
4. 控制焊点形态,保证一致性
回流焊通过精确控制温度曲线(加热速率、峰值温度、保温时间等),使焊锡熔化后形成均匀、饱满的焊点,确保同批次产品焊点质量一致,降低因焊点形态异常导致的设备故障风险。
三、空气炉、氮气炉、真空炉的区别
三种炉型的核心差异在于加热环境的气体氛围,由此导致适用场景、优缺点和成本的显著不同:
炉型
| 工作环境
| 核心优势
| 主要劣势
| 适用场景
|
空气炉 | 空气(含氧气约 21%)
| 成本低(无需气体供应)、结构简单、维护方便
| 焊点易氧化(氧气导致焊锡表面形成氧化膜),可能产生空洞、虚焊;不适合精密 / 无铅焊接
| 低端消费电子(如玩具、简单小家电)、对焊接质量要求不高的产品, |
氮气炉 | 氮气氛围(氧含量通常<500ppm)
| 减少氧化:氮气隔绝氧气,降低焊锡氧化概率,焊点光亮、空洞率低;适合无铅焊锡(无铅焊锡氧化敏感性更高)
| 需持续供应氮气,运行成本高;需控制氮气纯度(纯度不足影响效果)
| 中高端电子设备(如手机、电脑主板)、精密元器件(BGA、QFP)、无铅焊接工艺
|
真空炉 | 真空环境(气压<1atm)
| 消除气泡:真空环境可排出焊膏熔化时产生的气体(如助焊剂挥发物),避免焊点空洞;适用于高可靠性要求场景 | 设备昂贵、加热效率低(真空导热差)、生产速度慢;维护复杂 | 军工、航空航天、医疗设备等对焊点可靠性要求极高的领域(如卫星电路板、心脏起搏器)
|
四、回流焊的其他关键信息
1. 回流焊的温度曲线(核心工艺参数)
温度曲线是回流焊过程中PCB 表面温度随时间的变化规律,直接影响焊接质量,通常分为 4 个阶段:
a. 预热阶段(100-150℃):缓慢加热,使焊膏中的助焊剂挥发,同时避免 PCB 和元器件因升温过快产生热应力(防止 PCB 变形、元器件损坏)。
b. 恒温阶段(150-180℃):维持温度,让助焊剂充分活化,彻底去除焊盘和引脚表面的氧化层,同时使 PCB 各区域温度趋于均匀。
c. 回流阶段(峰值温度:无铅焊锡约 240-260℃,有铅焊锡约 210-230℃):温度超过焊锡熔点,焊膏熔化并润湿焊盘和引脚,形成焊点;峰值温度需严格控制(过高会烧毁元器件,过低则焊锡未完全熔化)。
d. 冷却阶段(快速降温至 100℃以下):焊锡快速凝固,形成致密的焊点结构,避免因缓慢冷却导致焊点晶粒粗大(影响强度)。
2. 影响回流焊质量的关键因素
• 温度曲线设置:是核心因素,需根据焊膏类型(有铅 / 无铅)、PCB 材质(FR-4、陶瓷)、元器件耐温性(如塑料封装元件忌高温)调整。
• 焊膏质量:焊锡粉末粒度、助焊剂活性直接影响熔化后的润湿性和焊点形态。
• PCB 与元器件可焊性:焊盘氧化、引脚镀层不良会导致焊锡无法润湿,产生虚焊。
• 炉内温度均匀性:炉内各区域温差需控制在 ±5℃以内(精密产品要求 ±2℃),否则会出现局部焊点未熔或过热。
3. 回流焊在 SMT 流程中的位置与关联
回流焊位于 “炉前 AOI 检测” 之后、“炉后 AOI 检测” 之前:
• 炉前 AOI 确保进入回流焊的 PCB 无印刷 / 贴装缺陷(如焊膏桥连、元器件偏移),避免缺陷在高温下恶化;
• 回流焊后进入炉后 AOI,检测焊接缺陷(如焊点空洞、虚焊、锡珠),形成完整的质量闭环。
4. 技术发展趋势
• 无铅化:因环保要求(欧盟 RoHS 指令),无铅焊锡(如 Sn-Ag-Cu 合金)已成为主流,其更高的熔点(比有铅焊锡高 30-40℃)对回流焊的温度控制精度提出更高要求。
• 智能化:现代回流焊炉配备实时温度监控(如炉内多个测温点)、自动调整温度曲线的功能,可通过 MES 系统与前道工序联动,动态优化工艺参数。
小型化适配:针对 01005 等微型元件和 Chiplet(芯粒)等先进封装技术,回流焊需实现更均匀的局部加热,避免微型焊点因温度波动产生缺陷。
 健翔升公司使用的是劲拓的JTR-1000回流焊设备,专为SMT电子组装设计,具备高精度温控和灵活配置能力。其核心参数包括:温度曲线设定(无铅焊接为例)涵盖预热区(室温至150℃,升温斜率≤2℃/s)、恒温区(150-180℃,60-90秒)、回流区(峰值235-245℃,持续10-20秒)及冷却区(降温速率3-5℃/s);传输速度可调范围0.1-1.5m/min,推荐0.8m/min适配多数PCB板;加热区配置8个独立温区,控温精度±1℃,总功率20kW。物理规格为重量580kg(净重),尺寸3.2m×1.5m×1.8m,电气需求三相380V±10%及压缩空气0.5MPa。优化建议包括针对高密度板降低传输速度至0.6m/min,热敏感元件峰值温度控制在230℃以下,并定期维护链条与温度传感器。该设备适用于消费电子至汽车电子等多场景生产。
健翔升公司使用的是劲拓的JTR-1000回流焊设备,专为SMT电子组装设计,具备高精度温控和灵活配置能力。其核心参数包括:温度曲线设定(无铅焊接为例)涵盖预热区(室温至150℃,升温斜率≤2℃/s)、恒温区(150-180℃,60-90秒)、回流区(峰值235-245℃,持续10-20秒)及冷却区(降温速率3-5℃/s);传输速度可调范围0.1-1.5m/min,推荐0.8m/min适配多数PCB板;加热区配置8个独立温区,控温精度±1℃,总功率20kW。物理规格为重量580kg(净重),尺寸3.2m×1.5m×1.8m,电气需求三相380V±10%及压缩空气0.5MPa。优化建议包括针对高密度板降低传输速度至0.6m/min,热敏感元件峰值温度控制在230℃以下,并定期维护链条与温度传感器。该设备适用于消费电子至汽车电子等多场景生产。


